 358
358
 2025-07-07
2025-07-07
中国粉体网讯 在我们日常生活中,智能手机、电脑、智能家居设备越来越智能,背后离不开芯片技术的飞速发展。就像城市发展从平房向高楼大厦演进一样,芯片制造也正在经历从二维结构到三维集成的变革。而玻璃基板键合技术,正是这场变革中让芯片"叠高楼"的核心工艺。
芯片制造的"后摩尔时代"挑战
过去几十年,芯片性能提升主要依靠制程微缩,也就是把芯片上的晶体管做得越来越小。当制程工艺逼近3nm以下时,遇到了物理极限,导致芯片发热严重、功耗剧增,依赖缩小尺寸提升性能的老路越走越窄,业界称之为"后摩尔时代"。
随着Chat GPT、无人驾驶等人工智能技术爆发,算力需求呈指数级增长。知名计算机专家吴军曾形容,Open AI每训练一次,就相当于3000辆特斯拉同时跑30多公里。这就要求芯片不仅算力强,还要功耗低,就像汽车既要跑得快,又要省油。传统二维芯片就像单层厂房,空间有限,而三维集成技术则把芯片变成"摩天大楼",通过立体堆叠大幅提升算力密度。
玻璃基板:三维芯片的"理想地基"
在三维芯片领域,玻璃基板堪称“理想地基”。其卓越的性能为芯片发展筑牢根基,凭借较低的介电常数,玻璃基板在高频信号传输中展现出强大优势,损耗远低于传统硅材料,为5G、6G乃至未来更高速的通信场景提供了稳定保障。同时,玻璃基板采用面板工艺生产,成本大幅降低至硅基方案的八分之一,且天然绝缘特性简化了工艺步骤,在提升生产效率的同时,有效控制成本。
玻璃通孔(TGV)技术作为玻璃基板应用的关键一环,更是为三维芯片搭建起高效“运输网络”。飞秒激光诱导刻蚀技术,以“光刀”精准加工出通孔,结合磁控溅射、蝶形电镀等工艺,构建出低阻导电通路。表面的多层铜布线(RDL),将信号对准误差控制在极小范围,如同精密的交通枢纽,让芯片间的信号传输既高效又精准,使玻璃基板成为推动三维芯片技术发展的理想之选。
键合工艺:让芯片"叠高楼"的"超级胶水"
键合工艺作为三维封装的核心技术,需在低温条件下实现异质材料界面高强度结合,并精准调控键合层的电学特性(绝缘/导通),是构建高可靠性三维互连架构的关键挑战。玻璃基键合技术通过界面化学重构与机械互锁机制,已广泛应用于MEMS谐振器、光子集成电路及微流控传感器的封装领域,其核心在于解决玻璃与硅、金属或聚合物等异质材料间的热-力-电协同匹配问题。
在玻璃基三维封装中,垂直互连通常依赖TGV通孔内的导电金属填充如(Cu、Ti)。通过物理气相沉积(PVD)结合电镀工艺实现通孔金属化后,需借助键合技术完成多层玻璃基板或芯片的堆叠集成。目前的键合工艺包括热压扩散键合、阳极键合、超高真空表面活化室温键合等。
热压扩散键合:热压扩散键合作为玻璃基三维封装的主流技术,通过热物理作用实现界面原子级互扩散。在高温下,特别是超过玻璃化转变温度时,玻璃的表面化学状态会发生显著变化,这些变化涉及表面化学键的重排或新的表面结构的形成,这是热压缩键合过程的基础。
阳极键合:阳极键合,又称电场辅助键合或静电键合,该技术通过热场与电场的协同作用,驱动玻璃中碱金属离子的定向迁移,实现玻璃与金属、半导体的原子级键合。在典型工艺中,玻璃-硅体系被加热至300~500℃的热激活温度区间,同时施加500-1500V直流电场,在这种情况下,玻璃材料变得更柔软,玻璃中的钠离子在电场驱动下向阴极迁移,形成厚度约10-50μm的钠耗尽层,与此同时,氧阴离子扩散至硅表面,与硅原子反应生成2-5nm厚的非晶态氧化硅过渡层,最终通过Si-O-Si共价键实现高强度界面结合。
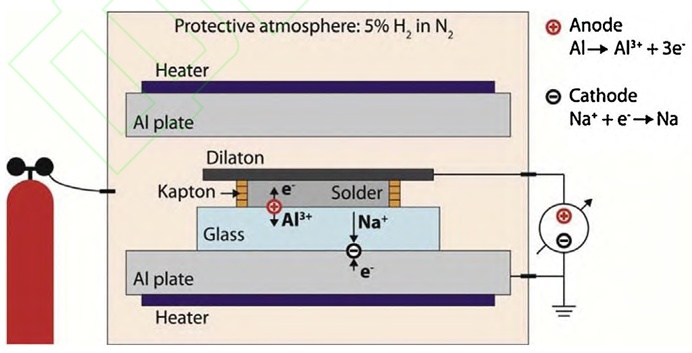
活化液体锡焊料阳极键合工艺示意图 来源:Wim.Optimized solder alloy for glass-to-metal joints by simultaneous soldering and anodic bonding
超高真空表面活化室温键合:为消除传统热键合工艺中热应力引发的界面失稳效应,研究者开发出基于超高真空表面活化改性的室温键合技术。该技术通过高能离子束轰击键合表面,实现污染物剥离与氧化层刻蚀,同时诱导表层原子化学态重构,暴露出高活性亚稳态原子层,进而在室温条件下通过物理接触即可形成高强度化学键合。
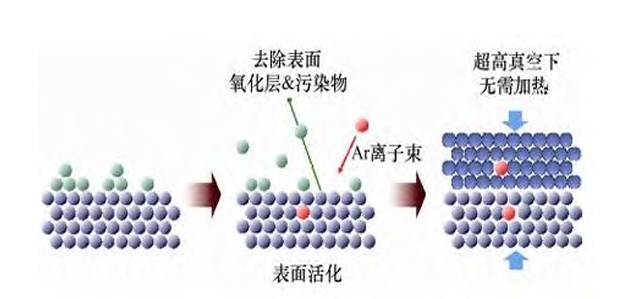
表面活化键合原理图 来源:《表面活化室温键合技术研究进展》(张洪泽等)
结语:
从手机到卫星,从AI到量子计算,玻璃基板键合技术就像芯片制造中的"隐形基建"。当我们惊叹于AI模型的智能、5G网络的速度时,正是这些看似微小的工艺创新,在幕后支撑着科技革命的大厦。随着技术不断突破,未来的芯片可能像乐高积木一样自由组合,而玻璃基板键合技术,正是连接这一切的"科技胶水",让更多不可能成为可能。
参考来源:
傅觉锋.玻璃基键合技术研究进展
张洪泽.表面活化室温键合技术研究进展
李文磊.玻璃通孔的结构控制方法及电磁特性研究
Wim.Optimized solder alloy for glass-to-metal joints by simultaneous soldering and anodic bonding
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!

2025-07-04
2025-07-03
2025-06-28
2025-06-25
2025-06-24
2025-06-24
2025-06-21
2025-06-19