 637
637
 2025-06-13
2025-06-13
中国粉体网讯 在电子信息技术飞速发展的今天,芯片作为各类电子设备的核心部件,其性能的提升不仅依赖于芯片设计与制造工艺的进步,芯片封装技术同样起着至关重要的作用。为了更好地理解玻璃芯技术,我们需要先从芯片封装的基础知识说起。
一片芯片制造完成后,封装工作便紧锣密鼓地展开。封装的首要任务是搭建起芯片与外界进行电气和信号交互的桥梁。想象一下,芯片就像一座功能强大的“数据处理城堡”,而封装则是城堡与外界连接的“交通网络”,只有通过这个网络,芯片才能接收外界的指令,输出处理后的结果。同时,封装还肩负着为芯片创造稳定工作环境的重任。如果没有封装,静电、灰尘等都可能对芯片造成不可逆的损害,就如同脆弱的艺术品暴露在恶劣环境中。
回顾芯片封装技术的发展历程,可谓是一部不断创新与突破的历史。早期的双列直插式封装,通过长长的引脚将芯片与电路板相连,这种方式虽然简单,但在集成度和信号传输速度上存在明显局限。随着技术发展,表面贴装、球栅阵列封装(BGA)以及芯片倒装等技术相继问世,它们逐渐缩小了封装体积,提高了信号传输效率。而如今,以2.5D/3D封装为代表的“先进封装”技术,更是将芯片封装带入了一个全新的时代。
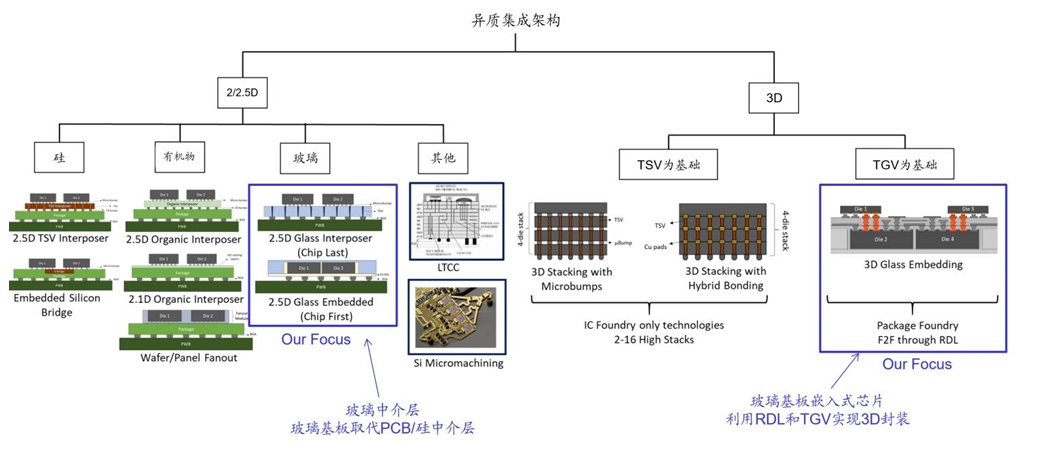
2.5D/3D封装基板与工艺路线图 来源:Madhavan.Heterogeneous integration for AI applications: status and future needs
先进封装技术的出现并非偶然,随着芯片集成度不断提高,芯片单元尺寸受到光刻掩模版尺寸限制的制约,同时传统的封装基板也难以满足多芯片间日益密集的互联需求。在这种背景下,中介层应运而生,它就像一座架设在芯片单元和基板之间的“信息高速公路”,内部可以承载更为密集的走线和互联,极大地提高了不同芯片单元之间的沟通效率,从而催生出了2.5D封装结构。
在对先进封装技术有了初步了解后,我们将目光聚焦到玻璃芯技术。电子互联解决方案厂商Samtec曾在相关演讲中介绍过玻璃芯技术,引发了行业内的广泛关注。从本质上来说,玻璃芯技术是采用玻璃材料作为核心部分,用于制造芯片封装所需的基板或中介层。在国外关于玻璃芯的科研和商用讨论中,虽然大家常常提及封装玻璃基板,但实际上更多指向的是玻璃中介层。
玻璃芯技术的应用场景十分广泛,不仅在2.5D先进封装中可作为芯片单元之间互联的中介层,在3D封装中,还存在“3D玻璃嵌入技术”,实现芯片的纵向堆叠。对比2.5D封装中玻璃、硅和有机三种解决方案可以发现,玻璃中介层不仅仅是单纯的中介层,它还同时承担着封装基板的角色。与硅和有机材料方案相比,玻璃中介层方案少了一个层级,这使得整个封装结构更加简洁紧凑。
尽管玻璃芯技术展现出了巨大的潜力,但在实际应用中仍面临诸多挑战,从材料特性来看,玻璃材料与金属的结合存在一定困难,这与玻璃通孔(TGV)技术中高质量金属填充的难题密切相关。玻璃表面光滑,导致金属在其表面的粘附性不佳,容易出现分层、脱落等问题,影响互联的稳定性和可靠性。在工艺方面,玻璃基板的制造工艺还不够成熟,需要进一步优化以提高生产效率和产品良率。此外,玻璃基板与现有封装产业链的兼容性也是需要解决的问题,只有实现与上下游产业的无缝对接,才能推动该技术的大规模应用。
目前,除了英特尔对玻璃芯技术进行积极探索外,三星电机等企业也对该技术表现出浓厚兴趣,可以预见,未来随着技术的不断发展和完善,玻璃芯技术有望在先进封装领域占据更重要的地位,为芯片性能的提升和电子设备的发展带来新的机遇。
参考来源:
广发证券《玻璃基板从零到一,TGV为关键工艺》
Madhavan.Heterogeneous integration for AI applications: status and future needs
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!

2025-06-12
2025-06-10
2025-06-09
2025-06-07
2025-06-06
2025-06-05
2025-06-04
2025-06-03