 15990
15990
 2025-12-08
2025-12-08
中国粉体网讯 在高速光互连领域,CPO(共封装光学)技术正成为突破性能极限的关键路径,而玻璃基板凭借独特优势,逐渐取代传统硅基与有机基板,成为CPO技术的核心支撑。面对数据中心、AI硬件等场景对带宽和功耗的严苛要求,玻璃基光电芯粒封装技术的创新与应用,正为下一代光通信系统注入强劲动力。
玻璃基板的核心优势在于其优异的机械稳定性、低介电损耗及与硅光芯片的高兼容性,既能承载高速电互连,又可通过嵌入式光波导实现低损耗光信号传输,大幅优化光芯片与光纤的耦合路径,提升系统集成度。相比硅基光电集成的高损耗与高封装成本,玻璃基CPO技术已在800Gbit/s至1.6Tbit/s光互连系统中展现出低功耗、高带宽的显著优势。
行业实践中,国内外企业与科研机构纷纷布局玻璃基CPO技术。2023年,康宁推出面向102.4Tbit/s数据中心交换机的玻璃基CPO方案,通过在玻璃基板上集成TGV(玻璃通孔)、RDL(重新分布层)和IOX玻璃波导,实现ASIC与PIC的高效互连,光纤耦合损耗低至1.5dB,单个基板可封装16个6.4Tbit/s光引擎。2025年,康宁进一步升级推出板级扇出型光电路板,集成1024条低损耗IOX波导,传输损耗仅0.1dB/cm,大幅简化了光交换机与服务器间的板级互连架构。

基于IOX波导的波导线路 来源:康宁
佐治亚理工大学的3D玻璃光子技术通过TGV和RDL实现电信号扇入扇出,借助透镜与波导结构达成低损耗光耦合;IBM将VCSEL(垂直腔面发射激光器)、EIC(电集成芯片)、PD(光电探测器)芯片倒装焊于玻璃基板,实现800Gbit/s带宽传输;雨树光科推出6.4Tbit/s CPO光引擎,适配HPC与AI集群需求;上海交通大学、深圳大学与深光谷科技合作研发的2.5D CPO方案,基于8英寸晶圆级TGV光电interposer工艺,支持多种光芯片倒装焊,形成800Gbit/s至1.6Tbit/s系列光引擎。
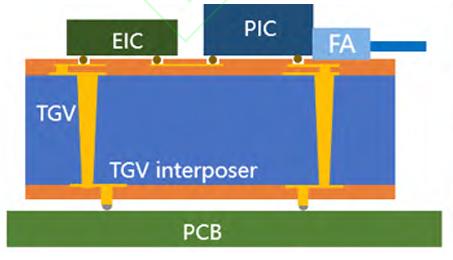
基于TGV Interposer的2.5D CPO的原理图 来源:深光谷科技
随着玻璃基光电集成封装技术的持续成熟,其应用场景正不断拓宽,尤其在光电一体化集成封装、高密度扇出型封装、功率半导体、微显示、可穿戴光电子及MEMS光电传感等领域展现出强劲适配性。依托TGV Interposer实现的2.5D/3D高密度光电集成封装,能够提供更优异的射频性能,有效提升封装密度,同时达成全固态与气密性封装效果,精准契合激光雷达、生物传感、光子陀螺等场景的核心应用需求。
为充分发挥玻璃基CPO技术的上述优势并推动其走向大规模应用,TGV Interposer需要聚焦于更高密度与更大尺寸的TGV制造、低损耗光波导与电互连的异质集成,以及面向CPO的多芯片、多材料3D堆叠架构。其中还需要克服一些工程化难点,主要包括:高深宽比TGV的无缺陷金属填充、玻璃与封装体系中多材料的热膨胀系数适配、面板级工艺的良率与成本控制,以及在高温、高频和高功率条件下长期可靠性的保障。此外,光—电—热—力多物理场协同设计与标准化封装接口也是实现规模化应用的关键挑战。
未来,随着行业实践的不断深入与技术难点的逐步攻克,相信玻璃基CPO技术将在数字经济与高端制造领域发挥关键支撑作用,开启光电集成的全新发展阶段。
参考来源:
葛畅.玻璃基光电集成封装及CPO应用
Bang.Optimizing Laser-Induced Deep Etching Technique for Micromachining of NXT Glass
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!

2026-02-07
2026-02-05
2026-02-02
2026-01-14
2026-01-13
2025-12-30
2025-12-22
2025-12-20